Nuovi memristori HfO2 con interfacce p-n asimmetriche aprono una strada concreta verso hardware neuromorfico ultraefficiente. I dispositivi basati su film sottili p-type Hf(Sr,Ti)O2 operano con correnti di switching fino a 10^-8 A, centinaia di livelli analogici stabili e un range di modulazione superiore a 50. La ricerca pubblicata su Science Advances il 20 marzo 2026 punta a ridurre il consumo energetico dell’intelligenza artificiale e dei futuri data center.
Cosa leggere
Memristori HfO2 superano i limiti dello switching filamentare tradizionale
I nuovi memristori HfO2-based affrontano uno dei problemi più critici dei dispositivi resistivi tradizionali: la variabilità dello switching filamentare. Nei memristori convenzionali, il passaggio tra stati resistivi dipende spesso dalla formazione e rottura di filamenti conduttivi localizzati, un meccanismo efficiente ma intrinsecamente stocastico. Questa variabilità limita uniformità, precisione analogica e affidabilità nei sistemi neuromorfici, dove ogni dispositivo deve funzionare come sinapsi artificiale stabile e riproducibile. Il nuovo approccio usa film sottili multicomponente Hf(Sr,Ti)O2 con comportamento p-type e un’interfaccia p-n autoassemblata con TiOxNy.

Le misurazioni elettriche sono state effettuate applicando una tensione agli elettrodi superiori in Mo, mentre l’elettrodo inferiore in TiN era messo a terra. Tutti i dispositivi allo stato iniziale presentano HRS. ( A ) Caratteristiche di commutazione resistiva (primi 30 cicli di scansione IV ) di un tipico dispositivo Mo/Hf(Sr,Ti) O2 /TiN/a-SiO2 / Si. L’inserto in (A) illustra schematicamente la sezione trasversale dello stack del dispositivo e la geometria della misurazione elettrica. ( B ) Dati di distribuzione LRS e HRS di 50 dispositivi ottenuti a -0,5 V. Le barre di errore nell’inserto in (B) rappresentano i valori medi di LRS e HRS determinati da 50 cicli IV . ( C ) Dati di resistenza determinati raccogliendo 1100 cicli di scansione IV consecutivi . ( D ) Valori di LRS e HRS ottenuti dai dati di resistenza in (C). ( E ) Dati di LRS e HRS determinati da misurazioni di resistenza pulsate applicando impulsi di ±3,5 V. ( F ) Dati di ritenzione LRS e HRS dopo l’applicazione di impulsi preimpostati di ±3,5 V. ( G ) Curve IV per tensioni di picco comprese tra ±0,75 e ±3,5 V con incrementi di ±0,25 V. ( H ) Valori LRS e HRS ottenuti dalle curve IV in (G). Le barre di errore in (H) rappresentano i valori medi di LRS e HRS ottenuti da 50 cicli IV per ciascuna tensione applicata. L’inserto in (H) mostra i corrispondenti rapporti HRS/LRS. I dati da (A) a (H) sono determinati da dispositivi con Mo d TE = 50 μm. ( I ) Valori LRS e HRS ottenuti da dispositivi con d TE = 25, 50 e 100 μm a -0,2 V. Questi dati sono stati raccolti da 50 dispositivi diversi per ciascun d TE .
Lo switching non dipende da filamenti casuali, ma da una modulazione interfacciale più controllata della barriera energetica. Questo consente una transizione graduale tra stati conduttivi, senza electroforming iniziale e senza compliance di corrente. Il risultato è un dispositivo più adatto all’apprendimento analogico, alla computazione in-memory e alle reti neurali spiking.
Hf(Sr,Ti)O2 introduce film sottili p-type compatibili con processi CMOS
I ricercatori realizzano i film sottili p-type Hf(Sr,Ti)O2 con una strategia di crescita in due fasi basata su sputtering magnetronico RF. La deposizione iniziale avviene in atmosfera non reattiva e genera uno strato sotto-stoichiometrico di circa 15 nanometri. Subito dopo, l’aggiunta di ossigeno produce uno strato sottile di circa 1 nanometro, controllando la composizione e favorendo la formazione dell’interfaccia funzionale. Questa architettura permette di ottenere un rapporto O/metal pari a 2,0, elemento cruciale per stabilizzare le proprietà elettroniche.

Potenziamento e depressione a lungo termine in funzione del numero di spike presinaptici con vari schemi di programmazione: ( A ) schema di spike identico; spike con ampiezze di 1,0, 2,0 e 3,0 V, ( B ) e ( C ) schema di spike identico; spike da 1,0 V con vari numeri di spike (intervalli di tempo dt = 1 ms). Gli spike presinaptici di ciascuno schema sono illustrati schematicamente sopra ogni pannello. La notevole riproducibilità dello schema di training da 6000 spike è stata confermata anche per diversi dispositivi, in accordo con la loro uniformità dispositivo-dispositivo basata sulla memoria. ( D ) Numeri e valori di conduttanza di questo lavoro confrontati con ~50 memristori basati su HfO2 riportati ( ulteriori dettagli forniti nella tabella S1) e ( E ) i loro rapporti Wmax / Wmin ( finestra analogica ) . ( F e G ) Dati di ritenzione multilivello ottenuti implementando spike identici da 1,0 V. Ogni livello è stato ottenuto dopo aver implementato 20 spike identici. L’addestramento dei dispositivi con un numero inferiore di spike potrebbe causare la sovrapposizione dei dati di ritenzione, principalmente a causa dei livelli di rumore presenti nelle correnti ultra-basse. Dati di potenziamento e depressione a lungo termine ottenuti utilizzando ( H ) uno schema di spike identici; spike da 1,0 V con dt crescente da 1 a 30 ms con incrementi di 1 ms, e ( I ) uno schema di spike non identici; spike con ampiezze che variano da ±0,6 a ±3,0 V con incrementi di ±0,1 V (dt = 1 ms).
La compatibilità con processi CMOS rende la tecnologia particolarmente rilevante per l’integrazione futura. L’ossido di afnio è già familiare all’industria dei semiconduttori, quindi l’uso di una piattaforma HfO2-based riduce le barriere verso la scalabilità produttiva. Il drogaggio con Sr e la presenza di Ti modificano il bandgap e favoriscono la natura p-type del materiale. Secondo le analisi, il bandgap scende da 6,0 eV a circa 4,5 eV, migliorando le condizioni per il controllo elettro-ionico della conduttanza.
L’interfaccia p-n asimmetrica controlla la barriera energetica
Il cuore del dispositivo è l’interfaccia p-n autoassemblata tra Hf(Sr,Ti)O2 p-type e TiOxNy n-type. Questa giunzione genera una regione di svuotamento estesa in modo asimmetrico dentro lo strato Hf(Sr,Ti)O2, con un potenziale built-in elevato e una corrente di saturazione estremamente bassa in polarità inversa. Il comportamento del memristore deriva quindi dalla modulazione controllata della regione depleta, non dalla formazione casuale di filamenti conduttivi.
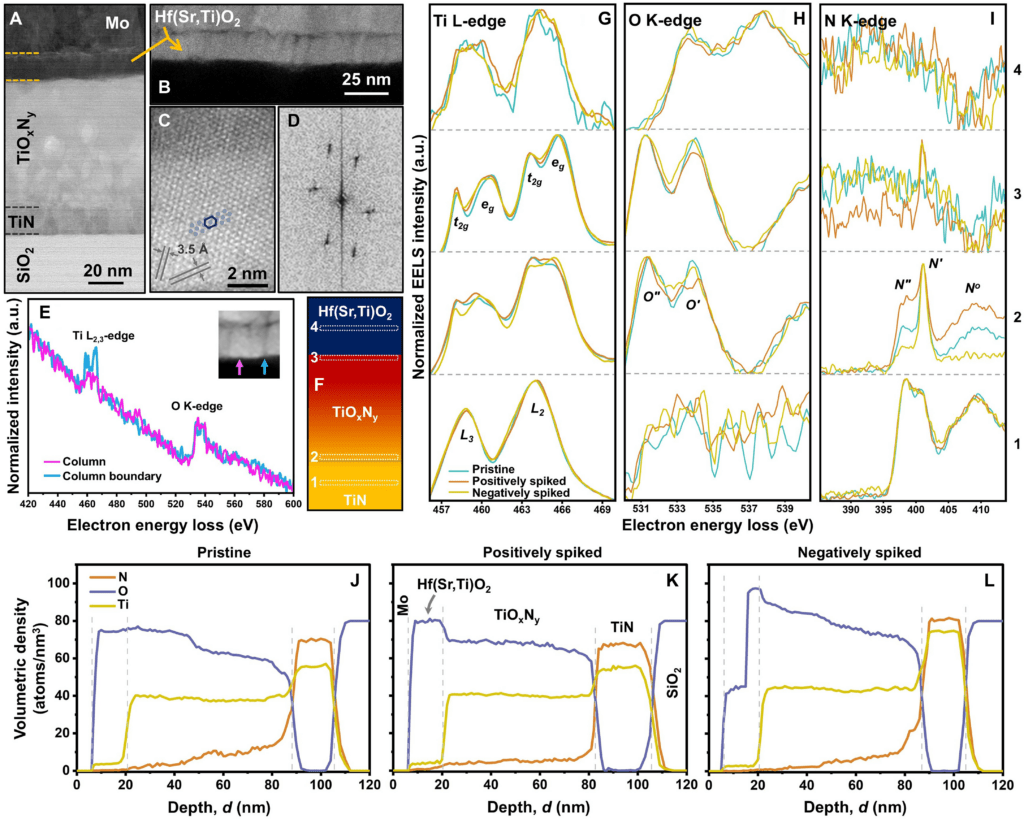
Immagine ABF-STEM in sezione trasversale ( A ) acquisita dal dispositivo Mo/Hf(Sr,Ti) O2 /TiN/a-SiO2 / Si allo stato iniziale e ( B ) immagine HAADF-STEM di Hf(Sr,Ti)O2 . Mentre il TiN conserva la sua densa microstruttura colonnare, lo strato di TiOxNy è costituito da cristalliti equiassiali ingranditi. ( C ) Immagine HAADF-STEM ad alta risoluzione dall’interno di una colonna di Hf(Sr,Ti)O2 con ( D ) la corrispondente immagine di trasformata di Fourier veloce che presenta riflessioni reciproche con un pattern a forma di esagono. ( E ) Spettri EELS Ti-L2,3 e OK acquisiti dall’interno di un confine di colonna brillante e di colonna scura, indicati dalle frecce nell’immagine HAADF-STEM inserita. I segnali OK di entrambe le regioni hanno intensità comparabili, a conferma che l’ossigeno è distribuito uniformemente in queste regioni. Tuttavia, l’intensità del segnale Ti-L 2,3 acquisito dal bordo della colonna è quasi raddoppiata rispetto all’interno della colonna, a dimostrazione che i bordi scuri della colonna sono ricchi di Ti. ( F ) Illustrazione schematica in sezione trasversale di Hf(Sr,Ti)O 2 /TiO x N y /TiN che indica le regioni da cui sono stati acquisiti gli spettri EELS ( G ) Ti-L 2,3 , ( H ) OK e ( I ) NK, allo stato iniziale e dopo l’aggiunta di spike. Profili di profondità della densità volumetrica assoluta di Ti, O e N di dispositivi ( J ) iniziali, ( K ) con spike positivo e ( L ) con spike negativo in funzione della profondità d . au, unità arbitrarie.
Quando vengono applicati spike positivi, buche ed elettroni vengono iniettati nel sistema e riducono lo spessore della regione depleta, abbassando la barriera energetica e aumentando la conduttanza. Gli spike negativi producono l’effetto opposto, allargando la regione depleta e favorendo il rilascio dei portatori intrappolati. La migrazione elettro-ionica di ossigeno e azoto contribuisce alla modulazione analogica. Questo meccanismo spiega la stabilità dei livelli intermedi e l’elevata uniformità tra cicli e dispositivi.
I dispositivi operano senza electroforming e senza compliance di corrente
Uno dei vantaggi principali dei nuovi memristori è l’assenza di electroforming. Molti dispositivi resistivi tradizionali richiedono un processo iniziale ad alta tensione per creare il percorso conduttivo, ma questa fase può introdurre variabilità, danni locali e differenze tra dispositivi. Nei memristori Mo/Hf(Sr,Ti)O2/TiN, lo switching resistivo interfacciale avviene direttamente, con transizioni graduali e controllabili tra stato ad alta resistenza e stato a bassa resistenza.

L’assenza di compliance di corrente semplifica ulteriormente il funzionamento. I dispositivi partono da uno stato ad alta resistenza e passano progressivamente verso una condizione più conduttiva con tensione positiva applicata all’elettrodo Mo. Con polarità inversa, la resistenza aumenta in modo continuo. Le curve I-V dei primi 30 cicli mostrano stabilità elevata e finestre di memoria superiori a 10. Questo comportamento analogico è essenziale per rappresentare pesi sinaptici in hardware neuromorfico.
Correnti di switching ultrabasse riducono il consumo delle sinapsi artificiali
Le correnti di switching fino a 10^-8 A sono uno dei risultati più rilevanti della ricerca. Nel contesto dell’hardware neuromorfico, ogni aggiornamento sinaptico deve consumare pochissima energia perché le reti possono contenere milioni o miliardi di connessioni. Una corrente così bassa permette di ridurre drasticamente il costo energetico per operazione, avvicinando i dispositivi elettronici al modello di efficienza del cervello biologico.
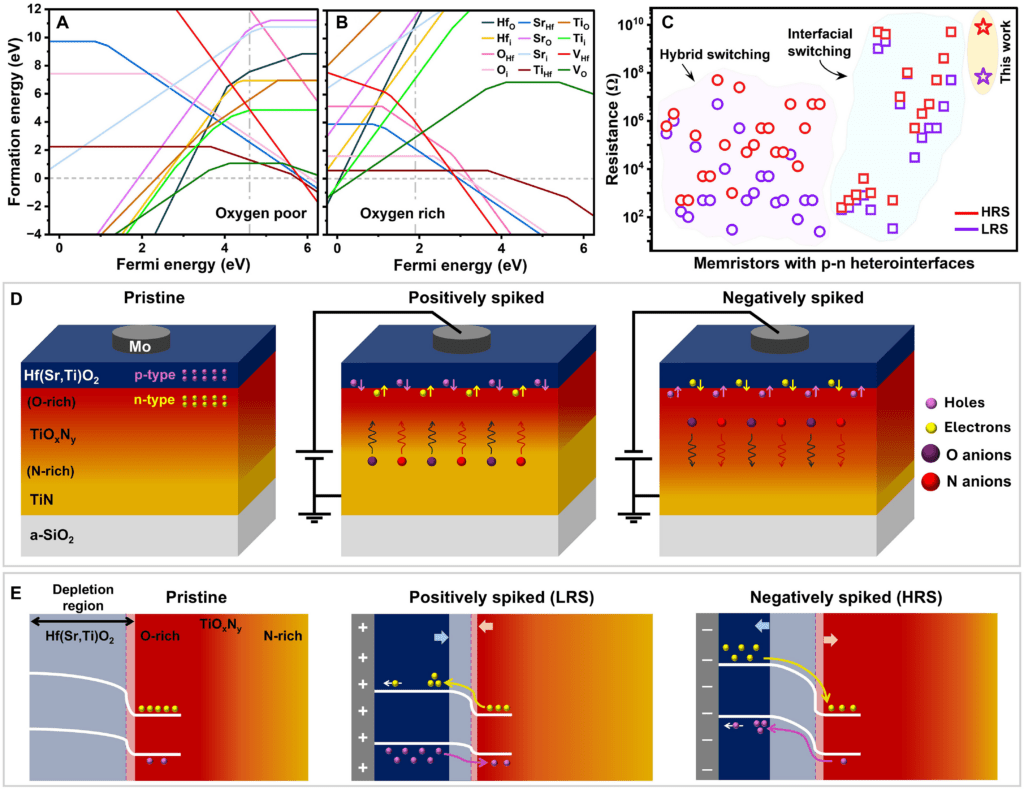
Energie di formazione di difetti e droganti calcolate per ( A ) Hf(Sr,Ti)O2 sottostechiometrico (carente di O) e ( B ) stechiometrico (ricco di O ) all’equilibrio . ( C ) Valori LRS e HRS di questo lavoro e di circa 40 memristori riportati con eterointerfacce pn realizzate con materiali diversi, incluso TiO2 di tipo n , e che mostrano commutazione resistiva interfacciale o ibrida filamentare-interfacciale. ( D ) Illustrazione schematica che riassume il modello di modulazione della conduttanza proposto per i dispositivi Mo/Hf(Sr,Ti)O2 / TiN/a-SiO2 / Si e ( E ) diagrammi delle bande di energia corrispondenti che cambiano in seguito all’applicazione di picchi.
L’energia per aggiornamento sinaptico si colloca tra 45 femtojoule e 2,5 picojoule, valori tra i più interessanti per dispositivi neuromorfici energy-efficient. Questa caratteristica rende i memristori Hf(Sr,Ti)O2 adatti a scenari in cui l’apprendimento deve avvenire direttamente sull’hardware, senza trasferire continuamente dati tra memoria e processore. La riduzione degli spostamenti dati è uno dei punti chiave del computing in-memory, soprattutto per applicazioni AI distribuite e dispositivi edge intelligenti.
Centinaia di livelli di conduttanza abilitano apprendimento analogico stabile
I dispositivi raggiungono centinaia di livelli di conduttanza analogici stabili e riproducibili, compresi tra 2,5 × 10^-9 S e 1,4 × 10^-7 S. Il range di modulazione supera 50 senza saturazione evidente, un risultato importante per rappresentare pesi sinaptici con precisione. Nei sistemi neuromorfici, la qualità dell’apprendimento dipende anche dalla capacità del dispositivo di modificare gradualmente la conduttanza senza salti casuali o instabilità. L’applicazione di spike identici a 1,0 volt produce potenziamento e depressione a lungo termine con buona linearità e simmetria dopo ottimizzazione degli intervalli temporali. Il numero di spike può variare da 100 a 12.000 senza perdita evidente del controllo analogico. Le misure su migliaia di impulsi confermano uniformità cycle-to-cycle e riproducibilità device-to-device. Rispetto a molti memristori HfO2 riportati in letteratura, questi dispositivi mostrano un equilibrio superiore tra basso consumo, livelli analogici e range dinamico.
Plasticità a breve termine e STDP avvicinano i memristori alle sinapsi biologiche
I memristori Hf(Sr,Ti)O2 non si limitano a memorizzare stati resistivi, ma emulano regole fondamentali dell’apprendimento neuronale. L’applicazione di spike a 1,0 volt genera plasticità sinaptica a breve termine, con fenomeni di paired-pulse facilitation e paired-pulse depression dipendenti dall’intervallo temporale tra impulsi. Le curve seguono decadimenti esponenziali doppi, richiamando il comportamento osservato nelle sinapsi biologiche con componenti rapide e lente. I ricercatori dimostrano anche STDP anti-Hebbiana asimmetrica, cioè una forma di plasticità dipendente dal tempo relativo tra spike pre-sinaptici e post-sinaptici. I cambiamenti di peso risultano massimi per valori di Δt più piccoli e decadono progressivamente con l’aumento dell’intervallo. Le misure con circa 40.000 spike confermano una stabilità operativa notevole. Questa capacità rende i dispositivi promettenti per reti neurali spiking e sistemi di apprendimento non supervisionato in tempo reale.
Caratterizzazione EELS XPS e Raman conferma il meccanismo elettro-ionico
Le tecniche di caratterizzazione confermano che lo switching è dominato dall’interfaccia p-n e dalla migrazione ionica direzionale. Le analisi EELS, XPS e Raman mostrano cambiamenti selettivi negli stati di ossidazione e nelle concentrazioni elementari in corrispondenza della giunzione tra Hf(Sr,Ti)O2 e TiOxNy. Questo supporta il modello in cui ossigeno e azoto migrano sotto campo elettrico, modulando la barriera energetica e la regione depleta. La microscopia elettronica a trasmissione evidenzia una struttura colonnare, con nanocolonne cristalline di circa 7 nanometri e confini arricchiti in Ti. Le misure RBS confermano la composizione stechiometrica, mentre XRD e Raman in situ durante i cicli di tensione mostrano diffusione dell’ossigeno verso la regione superiore. Il modello space-charge-limited current spiega la conduzione osservata. L’uniformità elevata deriva dalla distribuzione laterale omogenea dei difetti puntiformi e dalla qualità dell’interfaccia.
Ritenzione ed endurance rendono i memristori adatti a sistemi reali

La stabilità nel tempo è essenziale per passare da una dimostrazione di laboratorio a un sistema neuromorfico integrabile. I memristori Hf(Sr,Ti)O2 mostrano endurance con 1100 cicli I-V e oltre 50.000 cicli a impulsi, mantenendo un comportamento stabile. La ritenzione dei due stati binari supera 500.000 secondi, con finestra di memoria superiore a 10. Anche i livelli intermedi restano stabili per centinaia di secondi, un intervallo sufficiente per molti scenari di training online. La robustezza chimica del materiale è un altro elemento rilevante. Dopo 90 giorni di esposizione all’aria, i dispositivi non mostrano degrado prestazionale significativo. Questa stabilità riduce i rischi legati all’integrazione e alla manipolazione in ambienti non perfettamente controllati. Per l’hardware neuromorfico, che richiede grandi array di dispositivi con comportamento uniforme, endurance, ritenzione e stabilità ambientale sono parametri decisivi quanto il basso consumo energetico.
Il computing in-memory può ridurre il costo energetico dell’AI
La ricerca affronta un problema sempre più urgente: il consumo energetico dell’intelligenza artificiale. La crescita dei modelli AI e dei data center rende inefficiente il paradigma tradizionale von Neumann, in cui dati e calcolo restano fisicamente separati. Lo spostamento continuo di informazioni tra memoria e processore produce un costo energetico enorme, spesso superiore a quello dell’operazione aritmetica stessa. I memristori offrono una soluzione perché combinano memoria e calcolo nello stesso elemento fisico. Con il computing in-memory, i pesi sinaptici vengono memorizzati nella conduttanza dei dispositivi e aggiornati direttamente tramite impulsi elettrici. Questo può ridurre il consumo di oltre il 70 per cento rispetto ad architetture tradizionali, soprattutto in carichi neuromorfici e reti neurali spiking. I memristori HfO2 con interfacce p-n rendono questo scenario più credibile perché uniscono correnti ultrabasse, livelli analogici stabili, compatibilità CMOS e assenza di electroforming.
Memristori HfO2 aprono la strada a data center AI più sostenibili
L’impatto potenziale va oltre il singolo dispositivo. Se integrati in array neuromorfici, questi memristori potrebbero contribuire a ridurre il fabbisogno energetico dei futuri data center AI. L’intelligenza artificiale cresce con ritmi stimati intorno al 30 per cento all’anno in termini di domanda energetica, creando pressioni su infrastrutture elettriche, costi operativi e sostenibilità climatica. Hardware più efficiente diventa quindi un requisito industriale, non solo un obiettivo accademico. La compatibilità con processi CMOS rende i memristori Hf(Sr,Ti)O2 più interessanti rispetto a soluzioni basate su materiali difficili da integrare. I prossimi passi richiedono dimostrazioni su array più ampi, validazione a livello di rete completa e integrazione con circuiti di lettura e controllo. Tuttavia, i risultati attuali indicano una direzione chiara: l’ingegnerizzazione delle interfacce p-n può diventare una strategia generale per memristori analogici ultraefficienti e hardware brain-like a basso impatto energetico.
Iscriviti alla Newsletter
Non perdere le analisi settimanali: Entra nella Matrice Digitale.
Matrice Digitale partecipa al Programma Affiliazione Amazon EU. In qualità di Affiliato Amazon, ricevo un guadagno dagli acquisti idonei. Questo non influenza i prezzi per te.









